来源:Quasi-Physical Equivalent Circuit Model of RF Leakage Current in Substrate Including Temperature Dependence for GaN-HEMT on Si(TMTT 23年)
摘要
该文章提出了一种针对硅基氮化镓高电子迁移率晶体管(GaN-HEMT)的准物理等效电路模型,旨在模拟基板中的射频漏电流,并考虑了温度的影响。所提议的模型中,考虑了缓冲层与硅基板界面附近电子和空穴的作用以建模射频漏电流。通过技术计算机辅助设计(TCAD)仿真分析了射频漏电的物理机制,发现当漏极电压较高且温度较高时,射频漏电流会增加;这是因为在低受主浓度的缓冲层与硅基板界面处产生了反型层中的电子。
为了模拟射频漏电流,研究在Angelov-GaN大信号模型中添加了一个与GaN-on-Si物理结构相对应的C-R-C电路,即在漏源端之间。该C-R-C电路中的电阻和电容源自硅基板中电子和空穴密度的物理方程,以便考虑射频漏电流对温度和偏置的依赖性。经验证,所提出的模型能准确重现功率扫描的温度特性测量结果。结合了提出的准物理射频漏电模型的大信号模型能够模拟由硅基板中电子和空穴产生的外在射频漏电流导致的射频性能退化。此外,该模型也与漏极电极宽度对大信号特性的测量依赖性相符,证实了该模型对于晶体管及放大器设计的实用性。
关键词:氮化镓高电子迁移率晶体管(HEMT),反型层,建模,硅基板,温度。
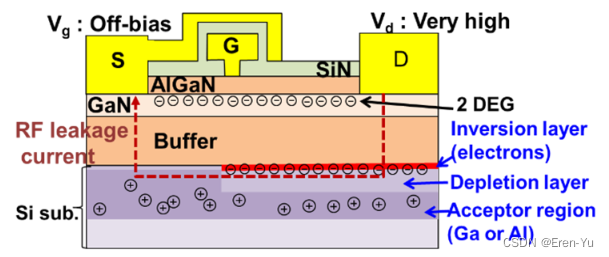
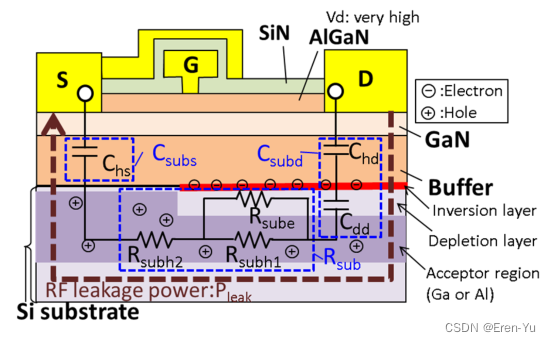
文章的研究内容
该文章主要研究并提出了一种针对硅基氮化镓高电子迁移率晶体管(GaN-HEMT)的射频(RF)漏电流的准物理等效电路模型,该模型特别考虑了温度对其的影响。研究中,作者Yutaro Yamaguchi和Toshiyuki Oishi分析了GaN-HEMT中RF漏电流的物理机制,发现在高漏电压和高温条件下,由于缓冲层与硅基板界面上低受主浓度区域形成反型层产生电子,导致RF漏电流增加。
为了准确建模这一现象,研究团队在现有的Angelov-GaN大信号模型基础上,增加了一个C-R-C(电容-电阻-电容)等效电路,这一电路结构反映了GaN-on-Si器件在漏源端之间的物理布局。此电路中的电阻和电容值直接从描述硅基板中电子与空穴密度的物理方程推导而来,从而确保模型能够准确反映温度和偏置电压对RF漏电流的依赖性。
经过验证,该模型能够精确地复现功率扫描的温度特性测量数据,表明它能有效预测由硅基板中电子和空穴引起的RF性能衰退。此外,模型还与实验测得的漏极电极宽度对大信号特性的影响相吻合,证明了其在晶体管和放大器设计中的实用价值。综上所述,这项工作不仅深化了对GaN-HEMT中RF漏电流物理机制的理解,还提供了一个实用的设计工具,有助于优化基于GaN的高性能微波和射频器件。
文章的研究方法
文章采用的研究方法主要包括理论分析、技术计算机辅助设计(TCAD)仿真和实验验证三部分,以建立和验证针对硅基氮化镓高电子迁移率晶体管(GaN-HEMT)的射频(RF)漏电流的准物理等效电路模型,该模型考虑了温度影响。
首先,通过理论分析,文章考虑了GaN-HEMT结构中缓冲层与硅基板界面附近电子和空穴的作用,来建模RF漏电流。理论分析揭示了在高漏电压和高温条件下,由于缓冲层与硅基板界面上形成的低受主浓度区域,电子在反型层中生成,从而增加了RF漏电流。
其次,利用TCAD仿真技术深入分析了RF漏电的物理机制。TCAD模拟帮助研究人员观察到随着漏极电压的提高和温度的升高,RF漏电流显著增加的现象,并且确认了这与界面处电子的生成有关。仿真还揭示了来自外延层扩散到接受区的空穴也是影响因素之一。
然后,根据仿真结果,研究团队在已有的Angelov-GaN大信号模型中添加了一个额外的C-R-C(电容-电阻-电容)电路,用以表征GaN-on-Si结构中漏源端的物理特性。这个C-R-C电路的电阻和电容值是基于物理参数(如电子和空穴浓度、电极的移动性和宽度)推导而来,确保了模型能够反映温度和偏置依赖性。
最后,通过实验验证了模型的有效性。模型预测的硅基板中电阻的温度特性与实测数据一致,同时,模型关于漏极电极宽度对大信号特性影响的预测也与实验测量结果相符。这表明提出的准物理模型能准确预测和解释实际GaN-HEMT器件中RF漏电流的温度依赖性及其对大信号特性的影响,为器件设计和性能优化提供了有力的理论支持。
文章的创新点
文章的创新点在于提出了一种新的准物理等效电路模型,专门用于模拟硅基氮化镓高电子迁移率晶体管(GaN-HEMT)中的射频(RF)漏电流,并考虑了温度依赖性。以下是几个关键的创新方面:
-
综合考虑电子与空穴效应:模型首次在GaN-HEMT的RF漏电流分析中同时考虑了缓冲层与硅基板界面附近的电子和空穴行为,这是以往模型中可能未充分考虑的一个重要方面。
-
基于物理机制的TCAD仿真分析:通过技术计算机辅助设计(TCAD)仿真,文章深入分析了RF漏电流产生的物理机制,明确指出在高漏电压和高温下,由于缓冲层与硅基板界面处低浓度受主区的电子反型层生成,以及从外延层扩散到接受区的空穴,导致漏电流增加。
-
准物理C-R-C电路模型的引入:为了更精确地模拟外在RF漏电流,作者在Angelov-GaN大信号模型基础上新增了一个C-R-C(电容-电阻-电容)电路,其参数直接来源于物理方程,包括电子和空穴密度的表达式,这样就使得模型能够反映温度和偏置条件下的漏电流变化。
-
设计参数与温度特性的关联:模型能够体现电极宽度(如漏极宽度)等物理结构参数如何影响大信号特性的温度特性,这为设计者提供了强有力的工具,可以预测并优化器件在不同工作条件下的性能。
-
实验验证与应用:提出的模型经过了实验验证,不仅成功复现了功率扫描的温度特性,而且与测量得到的漏极电极宽度对大信号特性的影响趋势一致,表明模型具有高度的实用价值,可用于预测和改善GaN-HEMT器件的RF性能,尤其是在面对由硅基板中电子和空穴引起的外在RF漏电流导致的性能退化问题时。
综上所述,该研究的创新点在于建立了更加精确、全面考虑物理机制的模型,为GaN-HEMT在RF领域的设计与性能优化提供了重要的理论基础。
文章的结论
文章结论提出了一个针对硅基氮化镓高电子迁移率晶体管(GaN-HEMT)中射频(RF)漏电流的准物理等效电路模型,此模型考虑了温度依赖性。研究发现,在高漏电压和高温条件下,由于缓冲层与硅基板界面处低浓度受主区形成电子反型层以及从外延层扩散至受主区的空穴,导致RF漏电流增加。为了准确模拟这一现象,研究通过物理表达式推导出的电阻和电容值,添加了一个对应于GaN-on-Si结构的C-R-C电路至Angelov-GaN大信号模型中。
验证结果显示,该模型能精确重现功率扫描的温度特性,有效模拟由硅基板中电子和空穴所引起的RF性能衰退。此外,模型还与漏极电极宽度对大信号特性影响的实测数据相吻合,证明了其在设计考虑温度特性影响的晶体管及放大器时的实用性。
因此,该研究不仅揭示了RF漏电流的物理机制,还提供了一个强大的设计工具,有助于工程师理解并应对由外在RF漏电流造成的RF性能下降问题,特别是在GaN-HEMT器件的设计与优化过程中,特别是在硅衬底的应用场景下。总结而言,该文的贡献在于推进了对于GaN-HEMT器件中复杂漏电流现象的理解,并为相关器件的性能提升和可靠性设计提供了科学依据。