参考视频:
1.7种常见的芯片封装形式,你了解几种?_哔哩哔哩_bilibili
2.看PCB板如何识别QFP,QFN_哔哩哔哩_bilibili
思维导图下载:
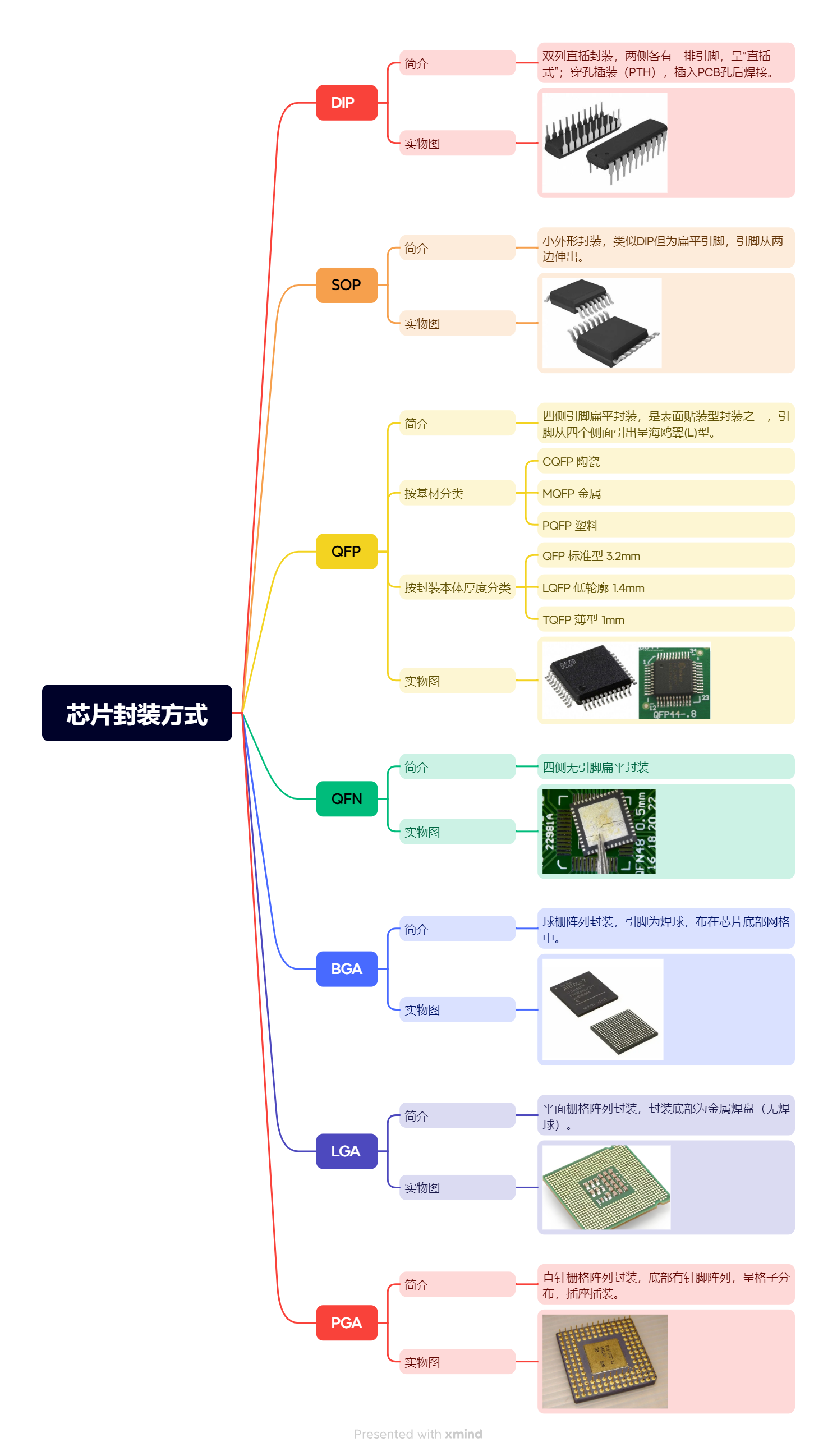
在半导体产业链中,芯片封装(Packaging)是连接芯片设计与下游应用的重要一环。封装不仅关系到芯片的散热性能、信号传输速度、机械保护 ,还直接影响产品的可靠性与成本 。随着工艺发展,芯片封装形式日趋多样化,但目前主流封装形式仍以以下7种为代表 :DIP、SOP、QFP、QFN、BGA、LGA、PGA。
一、DIP(Dual In-line Package)双列直插封装
-
结构特点:两侧各有一排引脚,适用于穿孔焊接(Through Hole)。
-
典型引脚数:8~64个。
-
优点:
-
易于手工焊接和原型设计;
-
结构坚固,适合教学/开发板。
-
-
缺点:
-
封装体积大,占用 PCB 空间;
-
不适合高密度布线。
-
-
典型应用:早期 MCU(如 ATmega16)、逻辑芯片、音频放大器。
二、SOP(Small Outline Package)小外形封装
-
结构特点:表面贴装(SMT)封装形式,引脚在两侧。
-
典型引脚数:8~44个。
-
优点:
-
体积小、重量轻,适合自动贴片;
-
成本较低,广泛应用。
-
-
缺点:
-
引脚较细,人工焊接难度大;
-
散热能力一般。
-
-
典型应用:EEPROM、Flash、接口IC(如RS-232芯片)。
三、QFP(Quad Flat Package)四边扁平封装
-
结构特点:四边引脚,呈扁平状伸出。
-
典型引脚数:44~256个。
-
优点:
-
引脚密度高,适合中高端处理器;
-
适合自动贴片机。
-
-
缺点:
-
引脚易弯曲,焊接难度较高;
-
占用PCB面积大于BGA。
-
-
典型应用:DSP芯片、ARM处理器、FPGA等。
四、QFN(Quad Flat No-lead)无引脚四边扁平封装
-
结构特点:四边无外露引脚,采用"焊盘"直接贴装。
-
典型引脚数:8~64个。
-
优点:
-
体积小、引脚电感低、信号完整性好;
-
散热性能优秀(底部焊盘可直接贴地层)。
-
-
缺点:
-
不易手工焊接及返修;
-
检测焊点困难。
-
-
典型应用:无线芯片、电源管理芯片、高速接口IC。
五、BGA(Ball Grid Array)球栅阵列封装
-
结构特点:引脚为底部焊球,阵列分布。
-
典型引脚数:100~2000+。
-
优点:
-
引脚数量多,适合高性能芯片;
-
热性能、电性能良好;
-
封装密度高。
-
-
缺点:
-
无法可视化检查焊点;
-
工艺要求高,返修复杂。
-
-
典型应用:CPU、GPU、FPGA、大容量存储芯片。
六、LGA(Land Grid Array)栅格阵列封装
-
结构特点:底部为金属接触面(Land),无球体。
-
优点:
-
接触面高度一致,适合高速连接;
-
散热良好,适合高频器件;
-
可以插座连接或直接焊接。
-
-
缺点:
-
易氧化,接触可靠性需保障;
-
焊接面压力大,PCB需高平整度。
-
-
典型应用:服务器CPU、通信芯片、嵌入式高性能模块。
七、PGA(Pin Grid Array)针脚阵列封装
-
结构特点:底部密集排列的针脚,引脚插入插座。
-
优点:
-
可插拔,适用于可更换设计;
-
引脚数量多。
-
-
缺点:
-
引脚易弯曲;
-
体积大,适合台式设备。
-
-
典型应用:早期Intel/AMD CPU、部分工业模块。
总结对比表
| 封装类型 | 引脚分布 | 安装方式 | 优点 | 典型应用 |
|---|---|---|---|---|
| DIP | 双列 | 插装 | 易焊接,适合原型设计 | 教学开发板 |
| SOP | 双列 | 贴片 | 小体积,广泛使用 | 存储/接口 |
| QFP | 四边 | 贴片 | 高引脚密度 | MCU、DSP |
| QFN | 无引脚 | 贴片 | 小封装,高性能 | 射频芯片 |
| BGA | 焊球阵列 | 贴片 | 高性能,多引脚 | CPU、FPGA |
| LGA | 焊盘阵列 | 焊接/插座 | 高速可靠,散热好 | 服务器CPU |
| PGA | 针脚阵列 | 插装 | 可插拔 | 台式机CPU |