前言: 封装,在芯片设计制造领域,顾名思义就是裸芯片用绝缘材料和金属引脚/焊球保护并封装成标准外形的过程和形式,MCU也属于芯片的一种,所以其也有自己的封装形式,本文仅仅基于瑞萨MCU介绍一下其常见的封装形式。
目录
[2.1 简介](#2.1 简介)
[2.2 主要结构组成](#2.2 主要结构组成)
[2.3 瑞萨MCU举例](#2.3 瑞萨MCU举例)
[3.1 简介](#3.1 简介)
[3.2 主要结构特点](#3.2 主要结构特点)
[3.3 瑞萨MCU的举例](#3.3 瑞萨MCU的举例)
[4.1 简介](#4.1 简介)
[4.2 主要结构特点](#4.2 主要结构特点)
[4.3 瑞萨MCU的举例](#4.3 瑞萨MCU的举例)
[5.1 简介](#5.1 简介)
[5.2 主要结构特点](#5.2 主要结构特点)
[5.3 瑞萨MCU的举例](#5.3 瑞萨MCU的举例)
[6.1 简介](#6.1 简介)
[6.2 主要结构特点](#6.2 主要结构特点)
[6.3 瑞萨MCU的举例](#6.3 瑞萨MCU的举例)
[7.1 简介](#7.1 简介)
[7.2 主要结构特点](#7.2 主要结构特点)
[7.3 瑞萨MCU的举例](#7.3 瑞萨MCU的举例)
1,关于封装
芯片封装就是给 "裸晶片" 穿上一件 "外衣",既能保护它,又能提供标准化的引脚接口,让工程师可以把它焊在 PCB 上使用。
它有两个核心作用:
机械与环境保护:保护芯片内部的硅片和金属互连不受外界湿气、灰尘、机械应力影响。
电气连接与散热:通过引脚、焊盘或焊球把芯片与电路板(PCB)可靠连接,同时帮助热量导出。
查看瑞萨官网中某一个MCU器件的概览一栏中会有封装选项,里面介绍的就是关于此款MCU的鞥封装类型,一般来讲常见的有以下几种:QFP、QFN、BGA、LGA、WLCSP、SSOP。
2,QFP封装
具体的实物样式如下所示

2.1 简介
QFP(Quad Flat Package)是方型扁平式封装技术(中文名称),是一种四侧带海鸥翼型引脚的表贴集成电路封装形式。其引脚间距可低至0.3mm,数量最多达304个,封装材料以塑料为主,另有陶瓷和金属材质 。该技术凭借体积小、寄生参数低的特点,广泛应用于微处理器、数字逻辑电路及高频场景。
2.2 主要结构组成
-
封装本体(塑料 /模塑体)(body)
-
引脚(leads / gull-wing leads)
-
倒角/弧角边缘(边角圆弧)
-
引脚脚距(pitch) --- 引脚间中心线之间的距离
-
引脚宽度、长度、弯折形态
-
底部贴装面(Seating Plane)与焊盘 footprint 接触面
2.3 瑞萨MCU举例
RL78F1X、RH850F1X都有此类的封装方式。
至于LFQFP ,它是 QFP 的改进型:更薄(Low-profile)、脚距更细(Fine-pitch),适合小型化和高引脚密度应用。
在瑞萨 MCU 中,大多数 车规 RH850 / 高性能 RX / RA 系列,只要型号带 "AFP" 或 "LFQFP",就是这类低厚度、细脚距 QFP。
常见的还有QFP / LQFP / LFQFP。


3,QFN封装

3.1 简介
QFN(Quad Flat No-leads Package,方形扁平无引脚封装),表面贴装型封装之一。值得注意的是,QFN封装与LCC封装完全不同,LCC仍有外延引脚,只是将引脚弯折至底部,而QFN封装则完全没有任何外延引脚。QFN是日本电子机械工业会规定的名称。
3.2 主要结构特点
-
引脚形式
-
四边均布的金属接触面,位于封装底部。
-
焊盘数量一般几十到上百不等。
-
-
厚度与体积
-
QFN 封装通常 厚度仅 0.8~1.0 mm,比 QFP 薄很多。
-
整体占板面积小,适合紧凑设计。
-
-
电气/热特性
-
引线很短,寄生电感/电阻更低,信号完整性比 QFP 好。
-
中心散热焊盘可把热量导入 PCB 铜层,热性能优于同尺寸 QFP
-
3.3 瑞萨MCU的举例
RL78G1X、F1X都有此类的封装方式。
至于瑞萨MCU中出现的HWQFN实际上是QFN的一种扩展封装类型。
HWQFN = Heat-enhanced / Half-thickness Quad Flat No-lead Package
本体更薄(比标准 QFN 低矮)。
底部有 裸露散热焊盘,提升散热性能。
常用于瑞萨 RA / RL78 / RX 系列中 低引脚数、对厚度和散热有要求的应用场景。

4,BGA封装

4.1 简介
BGA(Ball Grid Array,球栅阵列封装) 是一种 表面贴装封装形式,其特点是在芯片底部按照规则排列分布一系列焊球(solder balls)作为电气连接与机械固定的端子,而不是传统的引脚(leads)。这些焊球在回流焊过程中熔化,与 PCB 上对应的焊盘形成可靠的电气与机械连接。
4.2 主要结构特点
-
引脚数量大:常用于 176 pin、256 pin 甚至更高。
-
球距细(Fine Pitch):瑞萨的 BGN 常见 0.8 mm 或 0.5 mm pitch。
-
散热性能好:BGA 底部中间可以设计为裸露焊盘或加大球阵列用于散热。
-
适合高速接口:车规级 MCU(如 RH850、R-Car SoC)需要 DDR、以太网、CAN FD 等高速接口,BGA 封装能保证信号完整性。
4.3 瑞萨MCU的举例
RH850P1HC,RL78等系列几乎都有此类的封装方式,算是比较常见的一种芯片封装类型了
FBGA 是 BGA 封装的一种"细间距"版本 ,在瑞萨 MCU 中,常用于 高引脚数、高性能的汽车电子和高端嵌入式应用 。它比普通 BGA 封装更小、更薄,但对 PCB 设计、焊接工艺、检测要求更高。
VFBGA = Very Fine-pitch BGA ,即 超细间距球栅阵列封装 。
在瑞萨 MCU 中,它常见于 RA 高性能系列、RH850 车规 MCU、R-Car SoC ,主要用于 高引脚数、高速接口场景,是比标准 BGA 更小、更密集的一种封装形式。


5,LGA封装
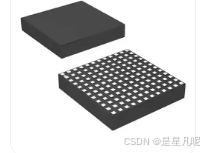
5.1 简介
LGA全称是Land Grid Array,直译过来就是栅格阵列封装,与英特尔处理器之前的封装技术Socket 478相对应,它也被称为Socket T。说它是"跨越性的技术革命",主要在于它用金属触点式封装取代了以往的针状插脚。而LGA775,顾名思义,就是有775个触点。
-
LGA (Land Grid Array):一种无引脚阵列封装形式。
-
与 BGA 的区别在于:
-
BGA 封装底部是 焊球;
-
LGA 封装底部是 金属平面焊盘(lands)。
-
-
LGA 芯片焊接时,这些平面焊盘直接与 PCB 上的焊盘通过锡膏/回流焊连接。
5.2 主要结构特点
-
无凸起焊球
- 底部是扁平金属焊盘,芯片更薄更轻。
-
封装厚度很低
- 适合对高度敏感的应用(如可穿戴设备、超薄模块)。
-
引脚间距小
- 常见 pitch 为 0.5 mm 或 0.65 mm。
-
电气与散热性能
-
焊盘到 PCB 的连接非常短,寄生电感/电阻更低。
-
底部也可设计 大面积裸露焊盘(exposed pad) 来增强散热与接地。
-
-
检查难度较高
- 与 QFN 类似,焊点不可见,需要 X-Ray 检测。
5.3 瑞萨MCU的举例
RL78G1X系列亦有此类的封装方式
而WFLGA 是瑞萨 MCU 提供的一种超薄、细间距的晶圆级 LGA 封装 。
它主要用于 RA / RL78 系列低引脚数 MCU ,特别适合 IoT、可穿戴设备、无线通信模组等对厚度和尺寸要求极高的应用。

6,WLCSP封装
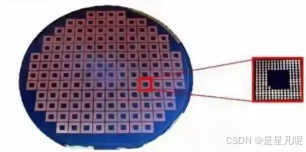
6.1 简介
晶圆片级芯片规模封装(Wafer Level Chip Scale Packaging,简称WLCSP),即晶圆级芯片封装方式,不同于传统的芯片封装方式(先切割再封测,而封装后至少增加原芯片20%的体积),此种最新技术是先在整片晶圆上进行封装和测试,然后才切割成一个个的IC颗粒,因此封装后的体积即等同IC裸晶的原尺寸。
6.2 主要结构特点
-
极小尺寸
-
封装面积 ≈ 芯片裸片面积,常见只有 2×2 mm、3×3 mm。
-
厚度很薄(通常 <0.5 mm)。
-
-
优异的电气性能
- 焊球短而直接,寄生电感、电容极低,非常适合高速信号与射频电路。
-
低制造成本
- 不需要复杂的塑封或引线键合,直接在晶圆级别完成凸点和重新布线。
-
适合移动/可穿戴应用
- 超小封装 + 超低厚度,非常适合智能手表、耳机、IoT 传感器等场景。
6.3 瑞萨MCU的举例
WLCSP 是瑞萨 MCU 提供的一种"最小体积、晶圆级封装"的形式 。
它在 RA 系列(RA2E1、RA4W1 等)和部分高端 MCU 中应用广泛,主要用于 对空间、功耗要求极高的 IoT、可穿戴、无线通信设备。

7,SSOP封装
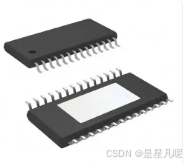
7.1 简介
SSOP(Shrink Small Outline Package)是一种表面贴装型集成电路封装形式,属于SOP(小外形封装)的改进型。该封装由飞利浦公司于1968-1969年开发,其引脚中心距从标准SOP的1.27mm缩小至0.635mm,封装厚度普遍在2.8mm以内。SSOP采用双列引脚布局,装配高度不超过1.27mm,适用于手机、平板等空间受限的电子设备。与DIP等传统封装相比,SSOP实现了更高的集成度和更优的电气性能,但散热能力较弱 1。
7.2 主要结构特点
-
外形与 SOP 类似
- 都是长方形塑封,两侧各一排引脚(鸥翼型 leads)。
-
"Shrink" 缩小
-
与标准 SOP 相比,SSOP 的 引脚间距更小(典型 0.65 mm 或 0.635 mm,对比 SOP 常见 1.27 mm)。
-
整体尺寸更小、更薄,适合更高引脚密度。
-
-
引脚数量
- 常见范围:16 引脚、20 引脚、28 引脚、48 引脚等。
-
适用场景
- 空间受限、成本敏感、引脚数不算太多的 MCU。
7.3 瑞萨MCU的举例
RL78/G1x 系列(超低功耗 MCU)
- 提供 SSOP-20 / SSOP-28 / SSOP-48 等封装选项,常用于家电、小型工业控制。
RX130 / RX111 系列
- 低引脚数型号也提供 SSOP-36 / SSOP-48 封装。
在瑞萨 MCU 中,SSOP 就是缩小型小外形封装 ,是一种 两侧引脚、间距更小的 SOP 。
它常用于 低引脚数、低功耗的 RL78 / RX 系列 ,尤其在 家电控制、车规低端模块、小体积工业设备中很常见。
TSSOP = 薄型 SSOP,适合节省高度但仍需较多 I/O 的应用。
LSSOP = 低高度 SSOP,更扁平,适合小体积/便携设备。

参考网站资料: