在半导体封装进入"无铅化"时代后,纯锡虽然成本低,但在实际应用中暴露出很多致命弱点。
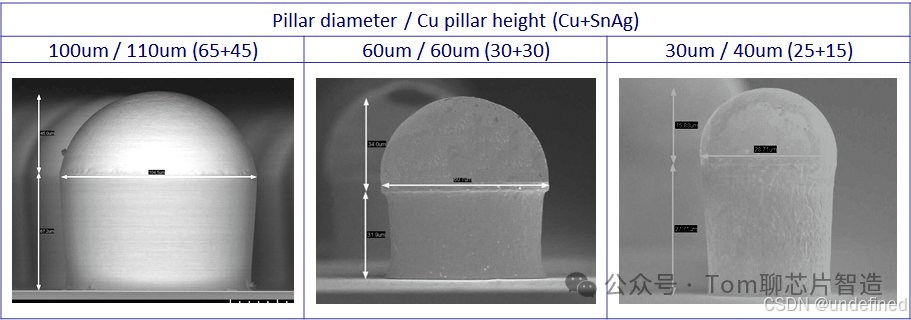
在纯锡中加入少量银(通常是 1.0% ~ 3.5% ),能在微观结构上引发"脱胎换骨"的变化。主要原因可以归结为以下四大核心优势:
1. 降低熔点,保护芯片
痛点: 纯锡的熔点高达 232°C 。为了让它在回流焊中完全熔化并良好焊接,炉温通常需要设定到 250°C 甚至 260°C 以上。这种高温会对娇贵的先进工艺芯片和有机基板造成严重的热损伤和翘曲。
当锡中加入 3.5% 的银时,会形成 Sn-3.5Ag 共晶合金,其熔点会骤降至 221°C 。
这看似不起眼的 11°C 降幅,大幅降低了封装过程中的热应力。
2. 提升力学可靠性
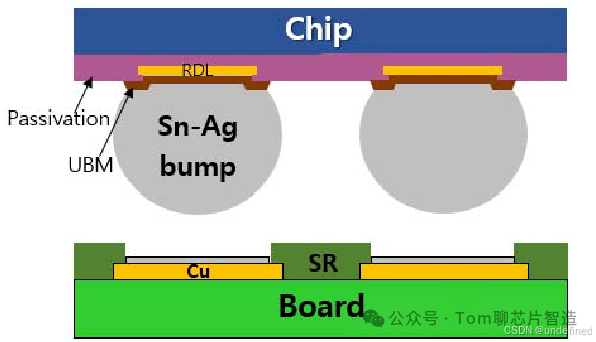
我们在前面聊过温度循环测试(TCT),凸点在冷热交替中最容易因为疲劳而产生裂纹。
银加入锡中后,并不会单纯地游离存在,而是会与锡发生反应,生成一种极硬的金属间化合物(IMC)颗粒------Ag3Sn 。
这些微小的 Ag3Sn 颗粒会均匀地散布在柔软的锡基体中。您可以把锡想象成"水泥",把 Ag3Sn颗粒想象成"钢筋"。
当凸点受到剪切应力、内部开始萌生微小裂纹时,裂纹一旦碰到坚硬的 Ag3Sn 颗粒就会被阻挡或被迫改变方向。它使得 Sn-Ag 凸点的抗热疲劳寿命比纯锡高出数倍。
3. 抑制致命的"锡须" (防短路)

纯锡在长期的压应力作用下,极易在表面长出像头发丝一样的单晶纯锡------锡须(Tin Whisker) 。这种毛刺具有极佳的导电性,一旦长得足够长搭接到旁边的引脚,就会造成毁灭性的短路次。
加入银并形成 Ag3Sn 颗粒后,不仅改变了锡晶格的内部应力分布,还能有效钉扎住晶界的移动。 极大地降低了锡须自发生长的概率,保证了芯片长期的电气可靠性。
4. 改善润湿性
纯锡在熔融状态下的表面张力较大,在 UBM(凸点下金属层)上的铺展和润湿能力一般,容易出现虚焊或气孔。
银元素的加入可以适度降低液态焊料的表面张力。在回流焊时,Sn-Ag 合金能更平滑、快速地包裹住铜盘或 UBM 层,形成饱满、完美的球形凸点。

Tom的晶圆电镀液业务:
1,晶圆镍铁电镀液,铜电镀液,金电镀液
2,桌面式晶圆电镀机,清洗机,湿电子在线分析仪
