TGV(Through Glass Via)工艺之所以选择在玻璃上打孔,主要是因为玻璃在以下五个方面相较于硅具有独特优势。
1. 低电损
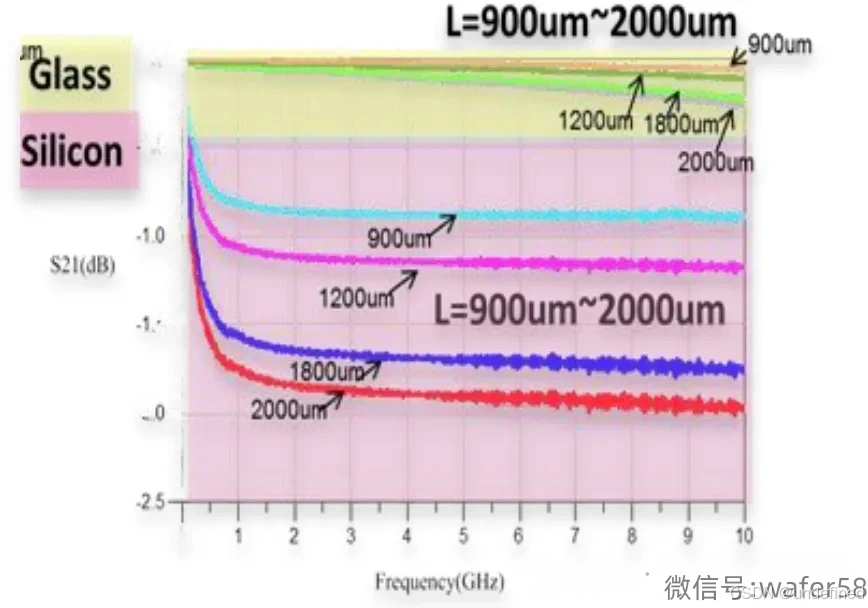
优势:
玻璃具有优异的电绝缘性;
高频信号下损耗小,适合射频(RF)、高频、高速I/O应用;
结果:
提升信号隔离;
降低系统功耗;
2,热膨胀系数可调节
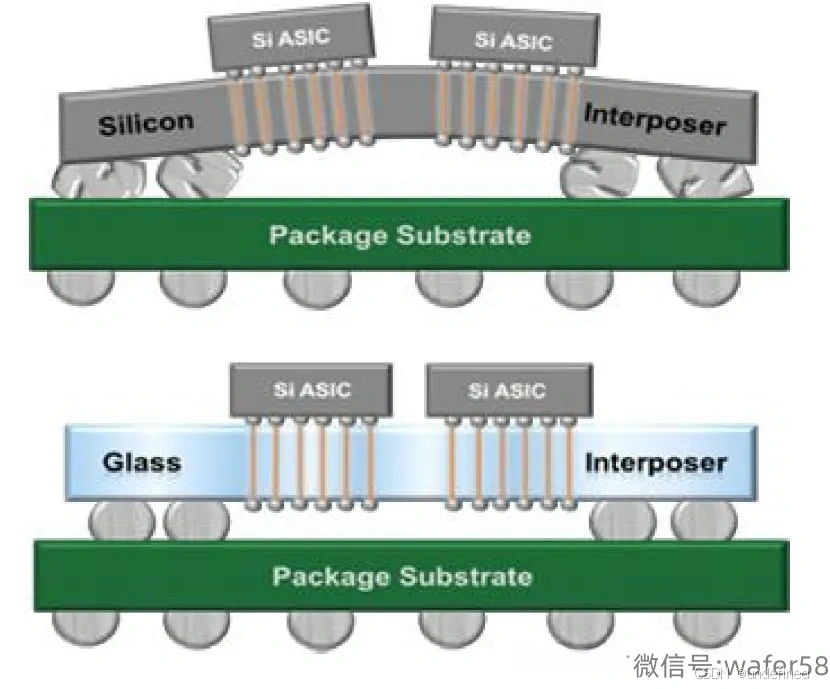
优势:
o玻璃可以通过成分调整实现多种CTE;
o更易匹配硅芯片;
结果:
o提升封装可靠性;
o在作为载板/中介层时可避免热应力失配引发的翘曲或裂纹。
3,表面光滑,利于精细线宽
优势:
o玻璃具有原生光滑表面,无需复杂抛光;
o更适合微细线/窄间距布线;
结果:
o支持更小封装尺寸;
o金属层更少 → 降低布线层数与制造成本。
4. 刚性好、平整度高
优势:
o相比有机材料(如FRP),玻璃刚性更大;
o不易变形,具有出色的平整度;
结果:
o支持高精度图形和细线路布线;
o保持TGV加工时的一致性和垂直性。
5. 适合直接成型
优势:
o可直接以目标厚度做出成品;
o无需后续研磨抛光;
结果:
o良率更高、成本更低;
o在大面板级封装(panel-level packaging)中更具效率和优势。
TGV工艺非常适合下一代高频、高密度、低功耗 封装需求,特别在2.5D/3D IC中介层 和面板级封装(PLP)中应用前景广阔。