01/简介
随着集成电路制程向3nm及以下节点突破,光刻系统面临的光学畸变、分辨率不足等问题愈发突出,光源-掩模协同优化(SMO)技术成为突破硬件限制的核心手段。矢量SMO凭借对偏振效应、三维掩模衍射等复杂光学现象的精准刻画,较传统标量模型实现了质的飞跃,其优化算法的性能直接决定光刻成像质量与制造良率。
梯度计算与变量替换是矢量SMO算法的理论基石,为离散优化问题转化为连续可解问题提供了关键路径;而同步型(SISMO)、交替型(SESMO)、混合型(HSMO)等优化策略,适配了不同工艺场景下精度与效率的平衡需求,光源后处理技术更打通了算法优化与实际制造的衔接壁垒。本文围绕上述核心要素,系统解析矢量SMO优化算法的内在逻辑与实践路径。
02/ 梯度计算与变量替换
矢量SMO的优化逻辑,以"梯度计算"与"变量替换"为核心:
• 目标函数梯度:目标函数对光源、掩模参数矩阵的梯度,由"像质评价函数梯度"与"各罚函数梯度"加权组合而成,是参数更新的核心依据。
• 像质评价函数梯度:考虑光刻过程中的离焦场景,梯度为"理想焦面像质梯度"与"离焦面像质梯度"的加权组合(通过加权因子调节两者占比),兼顾理想与实际工艺下的成像效果
• 光源罚函数梯度:通过特定函数约束光源参数,可有效提升光源的可制造性,避免优化后光源图形过于复杂。
03/优化策略与流程
同步型(SISMO):光源与掩模参数矩阵同步更新。
光源图形初始化为

SΩs和SΩM为光源优化步长和掩模优化步长。
收敛条件是Fk+1小于预定阈值或者迭代次数达到预定上限时。
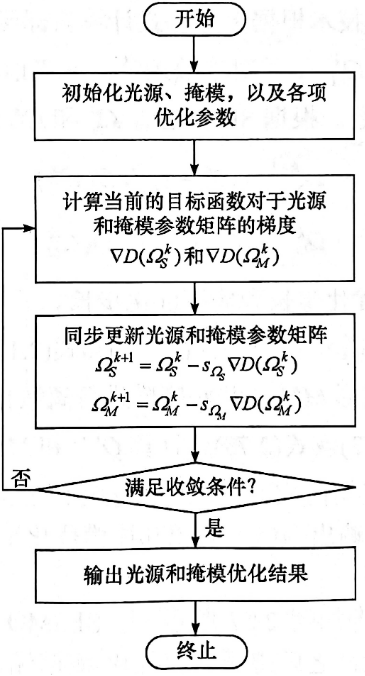
采用SD算法的SISMO流程图
交替型(SESMO):光源优化与掩模优化交替进行。
SESMO技术的初始化步骤与同步型SISMO技术相同。
收敛条件1是像质评价函数值Fk+1小于预定阈值,或SO迭代次数达上限;收敛条件2是像质评价函数值Fk+1小于预定阈值,或MO迭代次数达上限;收敛条件3是像质评价函数值Fk+1小于预定阈值,或SMO交替次数达上限。

SESMO技术的流程图
混合型(HSMO):先单优化光源(SO),再同步优化(SISMO),最后单优化掩模(MO)。

收敛条件1为当前的像质评价函数值小于预定阈值,或者SO迭代次数达到预定上限值;收敛条件2为当前的像质评价函数值小于预定阈值,或者SISMO迭代次数达到预定上限;收敛条件3为像质评价函数值小于预定阈值,或者MO迭代次数达到预定上限。
以下分别采用SD算法和CG为例,说明HSMO的优化流程:

采用SD算法的HSMO流程图

采用CG算法的HSMO流程图
04/光源后处理(提升可制造性)
像素化SMO技术能够对每个光源点的光强进行优化,虽然具有较高的优化自由度,但也会导致光源图形较为复杂。研究表明,当光源的光瞳填充率过大时会减小光刻PW。为了进一步提高PW并降低光源复杂度,我们提出一种光源后处理法。光源后处理法流程图如图所示。
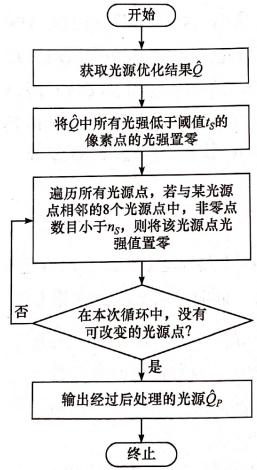
05/先进技术与未来发展方向
当前,矢量SMO优化算法已实现关键突破:梯度计算与变量替换技术高效破解离散优化难题,SISMO、SESMO、HSMO三类策略精准匹配不同工艺需求,其中HSMO通过"SO-SISMO-MO"分步策略平衡精度与效率,光源后处理技术则大幅提升优化结果的可制造性,支撑3nm制程量产。
未来,技术将向多维融合演进:AI赋能梯度计算实现策略自适应选择与参数动态调优;融入EUV光刻多物理场模型,提升复杂效应适配能力;构建跨流程协同框架,联动OPC与掩模制造优化。针对1nm及以下制程,量子化梯度模型与新型混合策略研发将成为核心,推动光刻分辨率与良率双重突破。