
01/简介
随着半导体技术节点向3nm及以下先进制程持续演进,光刻工艺中的光学邻近效应(OPE)、偏振依赖效应及三维掩模衍射等复杂现象愈发显著,传统基于标量近似的光学邻近修正(OPC)技术已难以满足纳米级图形复刻的精度要求。矢量成像模型凭借对光场偏振态、矢量传播及复杂界面相互作用的精准刻画,成为先进制程OPC技术的核心支撑,而矢量OPC优化算法的性能则直接决定了掩模修正的精度、效率及最终光刻良率,其技术突破已成为集成电路制造领域的关键研究课题。
在优化过程中,罚函数的合理引入为平衡成像精度与掩模制造可行性提供了关键支撑,二次罚函数、小波罚函数(WP)及广义小波罚函数(GWP)等不同形式的罚函数,通过梯度约束实现了对掩模复杂度、边缘平滑性等指标的精准调控,有效规避了过度修正导致的掩模制造难题。在此基础上,最速下降(SD)算法等经典优化算法凭借其简洁高效的特性,被广泛应用于矢量OPC优化流程中,通过梯度信息迭代更新掩模变量,实现目标函数的逐步收敛。
鉴于此,本文聚焦矢量OPC的优化算法体系,系统探讨目标函数梯度与掩模变量替换的协同机制,深入分析理想焦面及工艺变化场景下像质评价函数梯度的求解方法,阐释不同类型罚函数的梯度约束原理,并结合SD算法构建完整的矢量OPC优化流程,为提升先进制程光刻图形复刻精度及工艺稳健性提供理论支撑与技术参考。
02/ 目标函数梯度与变量替换
目标函数对掩模变量的梯度目标函数梯度(∇F)与各罚函数梯度(∇R₁、∇R₂)的加权组合:

为了将OPC优化问题由受约束优化问题转化为无约束优化问题,采用掩模变量替换将其从离散变为连续优化。
为将"约束优化问题"转化为"无约束优化问题",我们通过掩模变量替换(将离散的掩模参数转换为连续的参数矩阵)实现连续优化;替换后,目标函数对新参数矩阵的梯度,同样遵循"原函数梯度+罚函数梯度加权组合"的形式。
03/理想条件下的像质评价函数梯度
假设光刻系统采用常规照明模式(圆形、环形等),且各光源点照明强度一致,此时像质评价函数的梯度可通过"电场强度分量的傅里叶变换(FFT)加速计算"实现,同时结合掩模-参数矩阵变换的导数(如BIM、AlPSM等不同模型的导数形式)完成求解。
04/考虑工艺变化的像质评价函数梯度
考虑光刻系统的离焦、曝光量变化等因素,像质评价函数梯度为"理想焦面梯度"与"离焦面梯度"的加权和(通过加权因子调节两者占比)。其中,理想焦面与离焦面的梯度求解,均基于电场强度分量的卷积运算,并可通过"电场缓存技术(EFCT)"、FT替代卷积"等方法加速计算。
05/罚函数梯度
不同类型的罚函数对应不同的梯度形式:
二次罚函数梯度(以 AlPSM 模型为例):直接与掩模参数矩阵的元素相关联,通过线性组合实现约束;
小波罚函数(GWP)梯度:针对 0° 和 180° 相位区域分别应用小波变换,将两者的梯度加权求和,实现对掩模边缘的精细约束。
06/SD算法的OPC优化流程
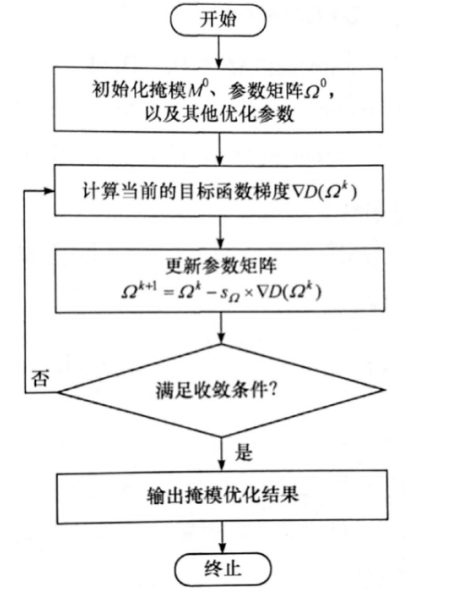
其中,初始参数矩阵的设置需匹配不同掩模模型(如 BIM、AlPSM 等),并通过微小扰动避免梯度近似为 0 的情况。
07/先进技术与未来发展方向
当前,矢量OPC优化算法已实现关键突破:目标函数梯度与变量替换技术提升了优化自由度,理想焦面及工艺变化适配的像质评价函数梯度,结合罚函数梯度精准控制约束条件,SD算法流程则保障了优化效率。先进应用中,梯度计算与异构算力融合,使3nm制程EPE控制达亚纳米级。
未来,算法将向多维度演进:AI与梯度计算结合实现自适应优化;融入多物理场梯度模型,适配EUV光刻复杂效应;跨流程协同优化梯度框架,联动SMO等技术提升全芯片良率。同时,极端制程将驱动量子化梯度模型研发,支撑1nm及以下技术突破。