目录
[1. 概述](#1. 概述)
[2. Innovus 中的 TSV / Bump / 背面金属建模](#2. Innovus 中的 TSV / Bump / 背面金属建模)
[3. 硬宏中的禁止区域定义](#3. 硬宏中的禁止区域定义)
[4. 禁止区域违规检查](#4. 禁止区域违规检查)
[5. Innovus 中的 3D IC 流程](#5. Innovus 中的 3D IC 流程)
[6. 设计导入](#6. 设计导入)
[7. 堆叠式 IC Verilog 输入](#7. 堆叠式 IC Verilog 输入)
[8. 堆叠配置输入](#8. 堆叠配置输入)
[9. 电源连接输入](#9. 电源连接输入)
[10. 芯片间接口同步与信息交换](#10. 芯片间接口同步与信息交换)
[11. TSV 与bump操作](#11. TSV 与bump操作)
[11.1 TSV / bump生成](#11.1 TSV / bump生成)
[12. 通孔(Feedthru)处理](#12. 通孔(Feedthru)处理)
[13. TSV 与bump布线](#13. TSV 与bump布线)
[13.1 TSV 到 IO 焊盘 / bump / 电源接地条纹的布线](#13.1 TSV 到 IO 焊盘 / bump / 电源接地条纹的布线)
[13.2 bump到bump的布线](#13.2 bump到bump的布线)
[14. 跨芯片连通性验证](#14. 跨芯片连通性验证)
[15. 导出文件](#15. 导出文件)
[用于 RC 提取和导轨分析](#用于 RC 提取和导轨分析)
1. 概述
3D IC 系统通常包含多个以三维方式连接的芯片(Die)。在传统 IC 中,输入输出(IO)引脚通过芯片一侧的凸点(Bump)或焊盘实现。为实现 3D 互连,芯片上需额外创建几个组件:
- 在芯片背面形成若干再分布层(RDL),使Bump可分布在芯片的正面和背面。
- 在正面金属层与背面再分布层之间的硅衬底上制造硅通孔(TSV)。
- 当芯片堆叠时,芯片间对齐的Bump构成了芯片间的数据传输路径。
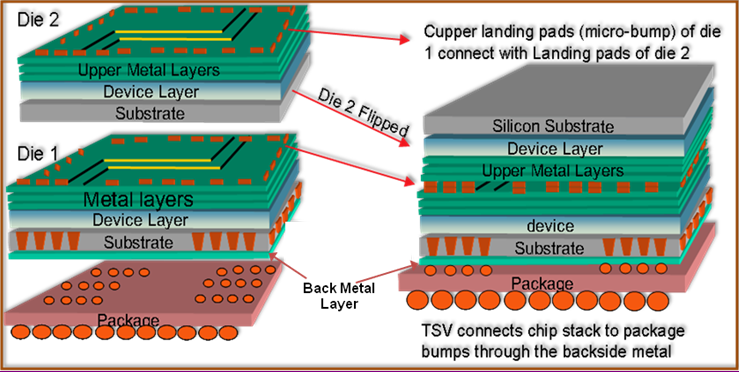 图 1 3D IC 剖面示意图
图 1 3D IC 剖面示意图
Innovus 支持 TSV 设计。在 Innovus 中,3D IC 的所有芯片被划分为多个层级(Tier)。每个层级包含若干芯片,且每个芯片可相对于封装进行翻转、旋转和偏移。通过 Innovus,设计人员能够:
- 指定多芯片系统配置(芯片间的互连关系、各芯片的相对位置)。
- 操作 TSV 和Bump。
- 进行协同设计。
- 同步所有芯片间的接口。
2. Innovus 中的 TSV / Bump / 背面金属建模
为建立芯片间的 3D 堆叠互连,需引入背面金属(MB)、TSV 和Bump。
-
背面金属(MB):是衬底背面的再分布层。
-
TSV(硅通孔):是穿透硅衬底的金属化通孔。TSV 的顶部覆盖层通常是第一层常规布线层(METAL1),底部覆盖层是背面金属(MB),因此背面金属与第一层金属通过 TSV 连接。
为实现芯片间的连接,会在顶层金属层或背面金属层上放置若干焊球(或焊柱)。这些焊球及其下方的金属焊盘在 Innovus 中被称为Bump**(Bump)** 。芯片间对齐的Bump称为ubump(Micro Bump)或着陆焊盘(Landing Pad) 。跨芯片的信号或电源通过微凸点在相邻芯片间传输。芯片与封装基板之间的Bump称为倒装芯片凸点(Flip Chip Bump)。
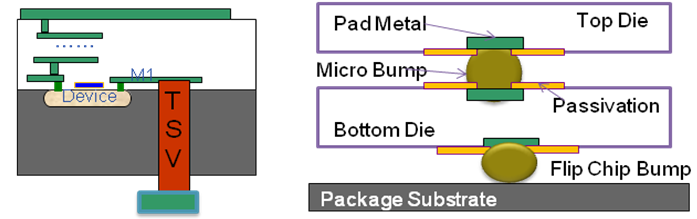 图 2 TSV 与bump横截面示意图
图 2 TSV 与bump横截面示意图
TSV 与bump横截面 背面金属、TSV 和bump的所有物理信息均在 LEF 文件(版本需为 LEF 57 或更高)中定义:
-
背面金属(MB)被建模为常规布线层(ROUTING) ,位于第一层常规金属之前,并为其分配 LEF 属性
BACKSIDE。 -
TSV 被建模为切割层(CUT) ,并分配 LEF 属性
TYPE TSV。
以下是 LEF 文件中用于定义 TSV 和背面金属的附加信息示例:
bump 的焊盘金属信息也在 LEF 文件中描述。bump 被建模为一个单元(Cell),该单元包含一个引脚,其形状和所在层与bump的焊盘金属一致。LEF 文件中不描述焊球的具体信息。
bump的另一种分类方式是基于其所在的金属层:
- 位于顶层金属层的凸点称为正面bump(Front Bump)。
- 位于背面金属层的凸点称为背面bump(Back Bump)。
- 微bump 可以是正面bump 背面bump,具体取决于芯片的堆叠方式。
示例
LEF 文件中描述 TSV 的语句如下:
PROPERTYDEFINITIONS
LAYER LEF58_BACKSIDE STRING ;
LAYER LEF58_TYPE STRING ;
...
END PROPERTYDEFINITIONS
LAYER MB # 背面金属层
TYPE ROUTING ;
PROPERTY LEF58_BACKSIDE "BACKSIDE ; " ;
...
END MB
LAYER TSV # 位于METAL1与MB之间的TSV切割层
TYPE CUT ;
PROPERTY LEF58_TYPE "TYPE TSV ; " ;
SPACING 20.0 LAYER OVERLAP ;
...
END TSV
LAYER METAL1 # 第一层金属
TYPE ROUTING ;
...
END METAL1
...
VIA VIAB1
RESISTANCE 0.01 ;
LAYER MB ;
RECT -11.00 -11.00 11.00 11.00 ;
LAYER TSV ;
RECT -5.00 -5.00 5.00 5.00 ;
LAYER METAL1 ;
RECT -7.0 -7.0 7.0 7.0 ;
END VIAB13. 硬宏中的禁止区域定义
可以在宏内部定义禁止区域约束,以避免bump / 相邻芯片边缘与这些区域发生重叠。如果在禁止区域内创建bump,Innovus 会报告警告,并且该禁止区域信息可传递给相邻芯片。
在硬宏中,可通过在宏的 LEF 文件中创建以下观察层(OBS)来指定阻挡区域:
-
正面钝化层
-
背面钝化层
-
顶层芯片的主切片层
-
底层芯片的主切片层
-
使用 LEF 文件中的钝化层来定义bump的禁止区域。
-
使用 LEF 文件中的主切片层来定义芯片边缘的检查区域。
LEF 文件中用于定义芯片边缘检查和bump禁止区域的语句如下:
# 背面凸点禁止区域层
LAYER BACKPASSIV
TYPE CUT ;
PROPERTY LEF58_TYPE "TYPE PASSIVATION ; " ;
PROPERTY LEF58_BACKSIDE "BACKSIDE ; " ;
END BACKPASSIV
# 正面凸点禁止区域层
LAYER TOPPASSIV
TYPE CUT ;
PROPERTY LEF58_TYPE "TYPE PASSIVATION ; " ;
END TOPPASSIV
# 顶层芯片边缘新层
LAYER TOPDIE
TYPE MASTERSLICE ;
PROPERTY LEF58_TYPE "TYPE ABOVEDIEEDGE ; " ;
END TOPDIE
# 底层芯片边缘新层
LAYER BOTTOMDIE
TYPE MASTERSLICE ;
PROPERTY LEF58_TYPE "TYPE BELOWDIEEDGE ; " ;
END BOTTOMDIE然后,在宏中为这些约束定义 OBS 层。OBS 层定义的示例语法如下:
......
OBS
LAYER TOPDIE
SPACING 10 ;
RECT -10 -20 100.940 70.885 ;
LAYER BOTTOMDIE
SPACING 5 ;
RECT 50 10 580 80.885 ;
LAYER TOPPASSIV
SPACING 20 ;
RECT 200 -10 300 20 ;
LAYER BACKPASSIV ;
RECT 400 0 500 50 ;要控制 OBS 层的可见性,请执行以下操作:
-
点击 "颜色首选项" 窗口的 "导线 / 通孔" 标签页(选项 - 所有颜色),选择这些层。
-
要控制
BACKPASSIV和TOPPASSIV上 OBS 层的可见性,请点击 "颜色首选项" 窗口的 "层" 标签页,选择这些层。 -
要控制
BOTTOMDIE和TOPDIE上 OBS 层的可见性,请点击 "所有颜色" 按钮,选择 "自定义" 标签页,然后选择这些层。
 图 3 OBS 层示例
图 3 OBS 层示例
4. 禁止区域违规检查
使用以下命令检查bump禁止区域违规:
verify_stacked_die -check_type {bump_keepout}该命令用于检查 OBS 层与bump(包括正面和背面bump)之间的重叠情况。
还可以使用以下命令检查相邻芯片间的芯片边缘违规:
verify_stacked_die -check_type {die_edge}一旦在宏内部定义了 OBS 层,相邻芯片的边缘不应与该 OBS 区域重叠。如果宏 OBS 与相邻芯片边缘之间存在违规,该违规将在图形用户界面(GUI)窗口中标记出来。
verify_stacked_die命令必须在执行readDieAbstract命令以导入相邻芯片的芯片摘要文件后使用。该命令会同时检查顶层和底层芯片的边缘违规。
5. Innovus 中的 3D IC 流程
下图展示了 Innovus 中 3D IC 设计的通用流程。该流程图仅包含 2 个芯片,但可扩展至多个芯片。
 图 4 Innovus 中的 3D IC 设计流程
图 4 Innovus 中的 3D IC 设计流程
Innovus 采用逐个芯片设计的方式。在设计一个芯片时,会考虑相邻芯片上的微bump及其实例,并对当前芯片上的ubump进行同步和优化。每个芯片的设计流程与常规设计流程非常相似,但需执行以下额外步骤:
-
设计导入阶段:需导入堆叠芯片的额外配置信息。
-
布局规划阶段:确保各芯片间的接口同步,并创建和分配 TSV / bump。
-
布局规划完成后:对 TSV 和bump进行布线。
-
验证阶段:验证芯片间的连通性。
 图 5 3D IC 设计中单个芯片的详细布局规划流程
图 5 3D IC 设计中单个芯片的详细布局规划流程
Innovus 提供TSV 工具盒 来执行各种 3D IC 流程任务。它包含 3D IC 流程中使用的表单,包括 TSV / bump操作、数据交换、TSV / bump布线和设计验证。选择tool - TSV可打开该工具盒。

图 6 TSV 工具盒的图形用户界面(GUI)表单
6. 设计导入
Innovus 将传统信息和堆叠芯片的额外信息作为每个芯片设计的输入。
7. 堆叠式 IC Verilog 输入
Innovus 会输入一个额外的顶层网表,用于描述芯片间和芯片与封装间的互连关系。在该顶层网表中,封装被设置为顶层模块;每个芯片被实例化,并描述芯片间的连通性。
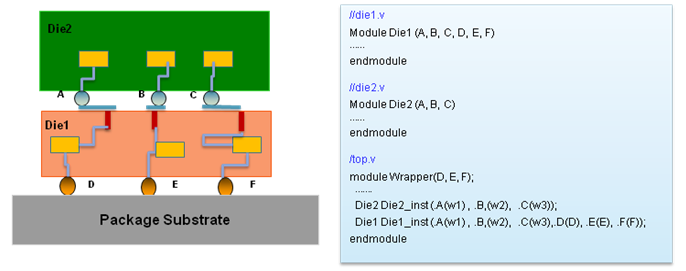
图 7 顶层网表示例
需要修改.globals设计文件以导入顶层网表。除了待设计芯片的模块外,顶层网表也应包含在.globals文件中。init_top_cell应设置为待设计芯片的模块名称。
以图 7 为例,在设计配置中,以下设置适用于Die1的设计:
set init_top_cell {Die1}
set init_verilog { Die1.v top.v }8. 堆叠配置输入
Innovus 会输入一个 XML 文件,该文件描述了每个芯片相对于封装的位置、翻转方向和朝向。该 XML 文件可通过readTSVConfig命令直接加载,或通过堆叠配置编辑器表单生成和编辑。
<StackChip>
<TopDesign name="top" offsetX=0.0 offsetY=0.0 orientation="R0" />
<Tier number=1>
<Chip name="Interposer" orientation="R0" faceUp="yes" llx=0 lly=0
sizeX=3740 sizeY=2340 scaleFactor=1 />
</Tier>
<Tier number=2>
<Chip name="mother_die" orientation="R0" faceUp="no" llx=100 lly=100
sizeX=2140 sizeY=2140 scaleFactor=0.8 />
<Chip name="daughter_die" orientation="R0" faceUp="no" llx=2300 lly=500
sizeX=1340 sizeY=1340 scaleFactor=1 />
</Tier>
</StackChip>
图 8 堆叠配置文件示例
9. 电源连接输入
使用一个文本文件来设置每个芯片上的电源 / 接地(P/G)网络配置。
P/G 网络有四种类型:
-
正面(Frontside):P/G 网络仅连接到正面bump。
-
背面(Backside):P/G 网络仅连接到背面bump。
-
可共享(Sharable):P/G 网络连接到正面和背面bump,以及芯片内的其他实例。
-
通孔(Feedthru):P/G 网络直接连接到正面和背面bump,不连接到当前芯片的任何实例;需使用别名(Alias)在不同芯片上定义相同的 P/G 网络。
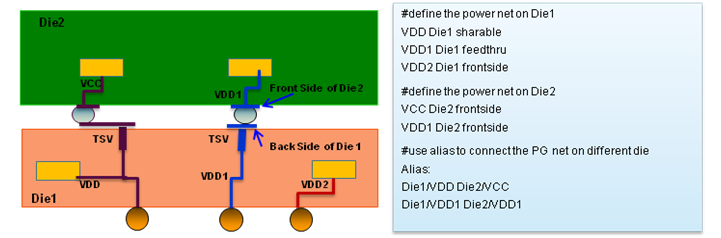 图 9 电源配置文件示例
图 9 电源配置文件示例
10. 芯片间接口同步与信息交换
在 3D IC 中,微bump是芯片间的数据 / 电源传输路径。如图 2 所示,微bump的焊盘必须精确对齐,以实现芯片间的连接。
Innovus 通过bump文件在芯片间传输bump信息。bump文件包含了一个芯片的所有bump信息。其流程如下:
-
从一个芯片中通过
writeBumpLocation命令导出bump文件。 -
在相邻芯片上调用
readBumpLocation命令。 -
readBumpLocation命令会根据相邻芯片上的凸点,在当前芯片上创建并分配微凸点。
 图 10 接口同步流程
图 10 接口同步流程
bump信息的写入 / 读取过程 可在两个相邻芯片之间迭代进行。如果其中一个芯片上的微bump 发生变化,该芯片的bump信息应被写入并由另一个芯片读取。
在设计一个芯片时,应参考并显示相邻芯片的信息。此步骤并非必需,但有助于跨芯片的优化和手动调试。其流程如下:
-
从一个芯片中通过
writeDieAbstract命令导出芯片摘要文件。 -
在相邻芯片上调用
readDieAbstract命令。 -
readDieAbstract命令会导入相邻芯片的信息,这些信息会在当前设计的芯片中显示并被参考。
11. TSV 与bump操作
Innovus 提供了创建 / 删除和分配 / 取消分配 TSV 和bump的功能。
11.1 TSV / bump生成
在 Innovus 中,有多种方法可创建 TSV / bump:
-
根据相邻芯片的凸点创建 TSV / bump
-
如果相邻芯片上有固定的微bump ,可使用
writeBumpLocation命令导出该芯片的bump文件。 -
然后在当前芯片中,使用
readBumpLocation命令导入该bump 文件,并指定-frontBump、-backBump和--tsvViaName选项,以创建相应的正面凸点、背面凸点和 TSV。
-
-
通过命令在当前芯片上创建 TSV / bump
-
如果相邻芯片上没有固定的微bump ,可运行
addTSV命令,并指定-addTSV、-frontBump和-backBump选项来创建相应的单元。 -
同时,可指定
-lowerLeftLoc、-pitchxy和-upperRightLoc选项来创建期望的 TSV /bump阵列。
-
由于 TSV 和bump 是芯片间的传输路径,应将 TSV 和背面bump放置在与背面连接到相邻芯片的 IO / 模块引脚附近。除非 TSV 必须与核心区域内的模块连接,否则应将其放置在核心区域之外(因为 TSV 会破坏跟随引脚)。
 图 11 GUI 中的 TSV / 凸点示意图
图 11 GUI 中的 TSV / 凸点示意图
11.2 TSV / bump分配
创建 TSV / bump后,您可以为信号和电源的 TSV、正面和背面bump进行分配。
-
**根据相邻芯片的凸点分配 TSV /**bump
- 如果相邻芯片上有固定的微bump,
read_bump_locations命令可帮助自动创建和分配凸点。
- 如果相邻芯片上有固定的微bump,
-
**通过命令在当前芯片上创建 TSV /**bump
-
运行
assignTSV命令,将网络分配给 TSV、正面和背面bump,以及 / 或通孔。-
assignTSV -frontBump:帮助将正面bump与 IO 引脚分配。 -
assignTSV -backBump:帮助将背面bump和 TSV 分配。 -
assignTSV -tsvViaName:帮助仅将指定的 TSV 单元分配。
-
-
12. 通孔(Feedthru)处理
在 3D IC 设计中,有一种特殊的网络称为通孔网络(Feedthrough Net)。通孔网络仅有两个引脚:一个是正面的 IO 引脚,另一个是背面的 IO 引脚。它不连接到芯片上的任何实例。
通孔网络在一个芯片上的定义,是为了实现正面和背面相邻芯片之间的连接,如图 12 所示。
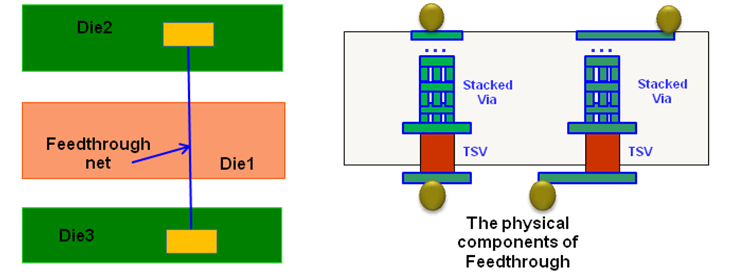 图 12 通孔的逻辑概念与物理组件
图 12 通孔的逻辑概念与物理组件
可以在 Verilog 网表中定义通孔网络,方法是将正面和背面的两个 IO 引脚一起分配。要创建一个通孔,可在addTSV命令中指定-tsvFeedthru参数。
assignTSV命令可通过开启和关闭-feedthru和-nonFeedthru参数,来同时或单独分配通孔网络和普通网络。assignTSV命令也支持嵌入式 TSV(该 TSV 被建模为背面金属上的一个引脚),但不会将该背面引脚分配给 TSV。
13. TSV 与bump布线
在 3D IC 设计中,用户通常需要将 TSV / bump布线到bump、电源 / 接地条纹、模块引脚和 IO 焊盘。Innovus 提供了多种布线引擎来支持 TSV / bump的布线。
13.1 TSV 到 IO 焊盘 / bump / 电源接地条纹的布线
-
TSV 到 IO 焊盘的布线
-
使用
fcroute命令的aio模式来支持 TSV 到 IO 焊盘的布线。例如:fcroute -type connect_bump_to_pad -designStyle detail -connectTsvToPad -routeWidth 3 -layerChangeTopLayer METAL4 -layerChangeBotLayer METAL1
-
-
TSV 到凸点的布线
-
Innovus 无法同时对正面和背面凸点进行布线,需分开操作。
-
示例:TSV 与背面凸点的布线
-
将顶层和底层布线层均设置为背面层,并定义额外配置
srouteExcludeBumpType。使用以下命令:fcroute -type connect_bump_to_pad -designStyle detail -routeWidth 8 -layerChangeTopLayer MB -layerChangeBotLayer MB -connectTsvToBump -extraConfig ./conf/backside.extraConf -
在
backside.extraConf文件中,需要定义"srouteExcludeBumpType FRONT_BUMP",其中"FRONT_BUMP"是正面凸点的单元名称。
-
-
示例:TSV 与正面 bump的布线
-
将顶层和底层布线层均设置为正面层,并定义额外配置
srouteExcludeBumpType。使用以下命令:fcroute -type connect_bump_to_pad -designStyle -routeWidth 8 -layerChangeTopLayer METAL4 -layerChangeBotLayer METAL1 -connectTsvToBump -extra_config ./conf/frontside.extraConf -
在
frontside.extraConf文件中,需要定义"srouteExcludeBumpType BACK_BUMP",其中"BACK_BUMP"是背面bump的单元名称。
-
-
-
TSV 到电源 / 接地条纹的布线
-
使用
fcroute命令的-connectTsvToRingStripe类型来对 TSV 和电源 / 接地条纹进行布线。例如:fcroute -type power -connectTsvToRingStripe -routeWidth 6 -layerChangeTopLayer METAL2 -layerChangeBotLayer METAL1
-
嵌入式 TSV 被建模为背面金属上的一个引脚,fcroute命令支持该引脚,并会对其进行参考。
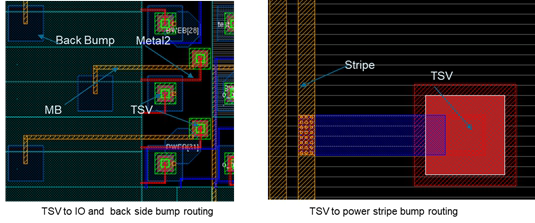 图 13 TSV / 凸点布线示意图
图 13 TSV / 凸点布线示意图
13.2 bump到bump的布线
-
正面 bump到正面 bump的布线
-
中介层(Interposer)设计中没有实例,需要将正面凸点直接连接。您可以使用 NanoRoute 来对其进行布线。使用以下设置和命令:
setNanoRouteMode -routeSelectedNetOnly setNanoRouteMode -routeConnectToBump routeDesign -
 图 14 凸点到凸点的布线示意图
图 14 凸点到凸点的布线示意图
-
-
正面bump到正面bump总线的布线
- 在连接 HBM 芯片和 SoC 芯片的中介层设计中,通常需要进行总线布线,以确保 HBM 芯片和 SoC 芯片之间的信号传输性能。本节阐述了中介层设计中总线布线的方法。
布线步骤:
-
创建非默认规则(NDR)和总线布线约束a. 以下命令定义了将在总线布线中使用的 NDR(在 METAL2 和 METAL4 层上,线宽为 2 微米,间距为 3 微米):
add_ndr -width {METAL2 2.0 METAL4 2.0} -spacing {METAL2 3 METAL2 3} -name bus_ndrb. 以下命令定义了将在布线中使用的总线网络约束。它要求工具仅使用 METAL2 作为总线布线层,并使用
bus_ndr作为布线规则。当连接到bump引脚时,工具可能会切换最后几节导线的层。setIntegRouteConstraint -type bus -topLayer METAL2 -bottomLayer METAL2 -rule bus_ndr -net {bus_net_1 bus_net_2 ...} -
设置层间屏蔽约束 在某些情况下,用户可能希望在信号布线层之间创建屏蔽线,这被称为层间屏蔽 。a. 层间屏蔽偏移以下示例定义了 METAL1 和 METAL3 层上,信号导线中心线与层间屏蔽导线中心线之间的偏移量(2.8 微米)。
setNanoRouteMode -interposerInterlayerShieldingOffsets {METAL1 2.8 METAL3 2.8}b. 层间屏蔽宽度以下示例定义了 METAL1 和 METAL3 层上,层间屏蔽导线的布线宽度(2 微米)。
setNanoRouteMode -interposerInterlayerShieldingWidths {METAL1 2.0 METAL3 2.0}c. 层间屏蔽层以下示例定义了层间屏蔽导线分别在 M2 和 M4 层的下方布线。
setNanoRouteMode -interposerInterlayerShieldingLayers {METAL2 bottom METAL4 bottom}d. 层间屏蔽网络名称以下示例定义了在 METAL1 至 METAL4 层范围内的屏蔽网络名称为 VSS。
setNanoRouteMode -interposerInterlayerShieldingNets {METAL1:METAL4 VSS} -
设置同层交错屏蔽约束 在某些情况下,用户可能希望在同层的信号布线之间创建屏蔽线,这被称为交错屏蔽 。a.
setFlipChipMode -constraintFile fc_shield.constb.fc_shield.const文件内容:以下示例定义了屏蔽宽度为 1.0 微米,屏蔽与信号的间距为 2.0 微米,屏蔽网络为 VSS。SHIELDWIDTH 1.0 SHIELDGAP 2.0 SHIELDSTYLE c SHIELDNET VSS -
在电源 / 接地bump上方创建电源 / 接地条纹
-
对受约束的总线网络和屏蔽进行布线
routeDesign -bump
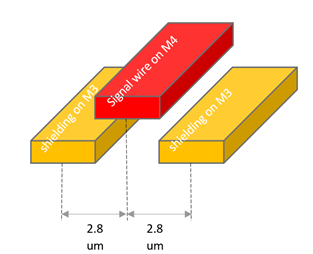 图 15 屏蔽图案示意图
图 15 屏蔽图案示意图 -
正面凸点到 TSV - bump 通孔网络的布线 在某些情况下,TSV 通孔和背面bump 会被封装在一起,形成一个新的bump 单元,称为TSV bump 。TSV bump 通常在正面、TSV 层和背面都有多个几何形状。
fcroute命令支持通过-connectTsvToBump选项和BUMP_AS_PAD约束,实现从正面凸点到 TSV - bump的布线。fcroute -type connect_bump_to_pad -connectTsvToBump -layerChangeTopLayer METAL4 - layerChangeBotLayer METAL1 --constraintFile fc.const -nets "net1 net2 ..."在
flipchip.const文件中,需要定义"BUMP_AS_PAD"约束,其中"TSV_bump_cell_name"是 TSV - bump的单元名称。BUMP_AS_PAD <TSV_bump_cell_names> END BUMP_AS_PAD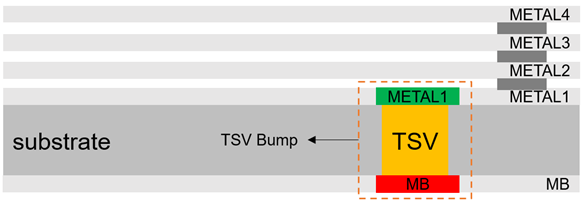 图 16 TSV - bump单元示意图
图 16 TSV - bump单元示意图 -
TSV / bump到模块引脚的布线 在 3D 堆叠芯片设计中,有时没有 IO 焊盘。TSV 和正面bump直接连接到模块引脚。Innovus 通过 NanoRoute 支持此功能。使用以下设置和命令:
setNanoRouteMode -routeSelectedNetOnly true setNanoRouteMode -routeConnectToBump true routeDesign
14. 跨芯片连通性验证
verifyConnectivity命令用于检查芯片间的连通性是否正确实现,即相邻芯片上具有相同信号的微bump是否对齐。
要检查单个芯片上的微bump对齐情况,您需要导出所有相邻芯片的芯片摘要文件,然后运行以下命令:
verifyConnectivity -tsv违规将显示在违规浏览器中,并且违规标记将显示在布局窗口中。
readBumpLocation -checkAlignment命令也可用于检查bump对齐情况。
15. 导出文件
设计完成后,Innovus 除了导出 DEF、GDSII 等常规文件外,还可以为 3D IC 设计导出额外文件。这些额外文件用于下游分析工具,如静态时序分析(STA)、提取和导轨分析。
用于静态时序分析(STA)
Innovus 能够创建一个顶层 SPEF 文件,该文件描述了芯片间的连通性。此 SPEF 文件中的 RC 值为 0,但仅写入芯片间的互连信息。该 SPEF 文件与每个芯片的 SPEF 文件一起,是 Tempus 进行静态时序分析的输入。使用以下命令:
createTSVNoLoadSPEF用于 RC 提取和导轨分析
Innovus 能够为 Quantus 和 Voltus 生成微凸点映射文件。该文件描述了相邻芯片之间微凸点的连接关系。
writeMicroBumpMappingFile- 总结